|
Здравствуйте Владимир (Ефименко). Я обучаюсь по программе повышения квалификации "Наноэлектронная элементная база информатики на основе полупроводников и ферромагнетиков". У меня проблема с тестом № 2 (к лекции № 2) по этой программе. Я несколько раз пытался пройти этот тест, но больше 50 баллов набрать не удаётся, хотя я всё делаю в соответствии сматериалом лекции. В заданиях этого теста есть ошибки, которые видны невооружённым глазом. Обращаюсь к Вам как к инспектору этой программы повышения квалификации. Найдите возможность исправить ошибки в тесте № 2. Из-за остановки на этом тесте я не могу двигаться дальше, а у меня очень ограниченное время на освоение этой программы. Заранее благодарен Вам за внимание к моим проблемам и помощь. |
Наноэлектронная элементная база информатики на полупроводниках группы А_ІІІВ_V. Гетеротранзисторы
Гетеротранзисторы с резонансным туннелированием
На наноэлектронном этапе развития функциональные возможности и характеристики биполярных и полевых транзисторов на основе полупроводников группы  удалось дополнительно улучшить благодаря использованию резонансного туннелирования, о котором речь шла в
"Качественные изменения свойств при переходе к наноразмерным элементам "
(п. 3.5). Вы уже знаете, что вольтамперная характеристика двойного туннельного барьера с квантово-размерным промежуточным слоем (ДТБР) является ВАХ N-типа и имеет участок с отрицательным дифференциальным сопротивлением.
ВАХ двойного туннельного барьера, рассмотренная в
"Качественные изменения свойств при переходе к наноразмерным элементам "
(
рис.
3.8, справа) в виде зависимости электрического тока от приложенного напряжения, воспроизведена на
рис.
8.7 слева в виде обратной зависимости – электрического напряжения на ДТБР от протекающего электрического тока. Видно, что эта зависимость на участке от
удалось дополнительно улучшить благодаря использованию резонансного туннелирования, о котором речь шла в
"Качественные изменения свойств при переходе к наноразмерным элементам "
(п. 3.5). Вы уже знаете, что вольтамперная характеристика двойного туннельного барьера с квантово-размерным промежуточным слоем (ДТБР) является ВАХ N-типа и имеет участок с отрицательным дифференциальным сопротивлением.
ВАХ двойного туннельного барьера, рассмотренная в
"Качественные изменения свойств при переходе к наноразмерным элементам "
(
рис.
3.8, справа) в виде зависимости электрического тока от приложенного напряжения, воспроизведена на
рис.
8.7 слева в виде обратной зависимости – электрического напряжения на ДТБР от протекающего электрического тока. Видно, что эта зависимость на участке от  до
до  не является однозначной. Участок с отрицательным дифференциальным сопротивлением при управлении электрическим током не является стабильным, но два других участка соответствуют стабильным состояниям ДТБР.
не является однозначной. Участок с отрицательным дифференциальным сопротивлением при управлении электрическим током не является стабильным, но два других участка соответствуют стабильным состояниям ДТБР.
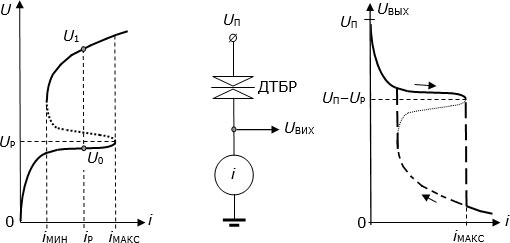
Рис. 8.7. Слева – зависимость напряжения на ДТБР от протекающего электрического тока. В центре – схема включения ДТБР последовательно с источником тока. Справа – выходная характеристика такой схемы
При протекании электрического тока  , в зависимости от предыстории, ДТБР может находиться в одном из двух разных состояний. В одном состоянии на этом элементе падает напряжение
, в зависимости от предыстории, ДТБР может находиться в одном из двух разных состояний. В одном состоянии на этом элементе падает напряжение  , в другом –
, в другом –  . Поэтому в принципе на таком элементе может быть построена ячейка памяти с двумя состояниями – логического "0" и логической "1".
. Поэтому в принципе на таком элементе может быть построена ячейка памяти с двумя состояниями – логического "0" и логической "1".
На
рис.
8.7 в центре показан вариант принципиальной электрической схемы, когда ДТБР подключен к источнику напряжения питания UП последовательно с источником тока, позволяющим плавно регулировать величину электрического тока ( ). Таким элементом может быть, например, гетеротранзистор (биполярный или полевой). Справа показана зависимость выходного напряжения такой схемы (
). Таким элементом может быть, например, гетеротранзистор (биполярный или полевой). Справа показана зависимость выходного напряжения такой схемы ( ) от электрического тока
) от электрического тока  . При малых значениях тока падение напряжения на ДТБР тоже невелико, и выходное напряжение примерно равно напряжению питания.
При возрастании тока падение напряжения на ДТБР увеличивается, и выходное напряжение падает. А когда величина тока достигает резонансного значения
. При малых значениях тока падение напряжения на ДТБР тоже невелико, и выходное напряжение примерно равно напряжению питания.
При возрастании тока падение напряжения на ДТБР увеличивается, и выходное напряжение падает. А когда величина тока достигает резонансного значения  , ДТБР очень быстро (за доли пикосекунды) переходит в другой режим, и напряжение на выходе резко падает. Это позволяет в логических схемах на гетеротранзисторах получать очень крутые фронты сигналов, что содействует повышению быстродействия и надежности таких схем.
, ДТБР очень быстро (за доли пикосекунды) переходит в другой режим, и напряжение на выходе резко падает. Это позволяет в логических схемах на гетеротранзисторах получать очень крутые фронты сигналов, что содействует повышению быстродействия и надежности таких схем.
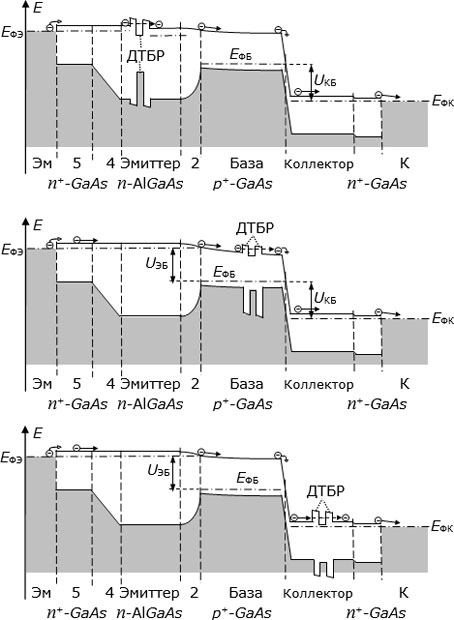
Рис. 8.8. Энергетические диаграммы биполярного гетеротранзистора в случаях, когда ДТБР встроен: вверху – в область эмиттера; в центре – в область базы; внизу – в область коллектора
Технология эпитаксиального наращивания, ставшая доступной на "наноэлектронном" этапе развития, позволяет встроить очень тонкую гетероструктуру ДТБР (обычно это структура  или другие аналогичные комбинации толщиной порядка единиц нанометра) в любую область биполярного гетеротранзистора – в эмиттер, базу или в коллектор. Соответствующие энергетические диаграммы показаны на
рис.
8.8. Здесь обозначения такие же, как и на
рис.
8.6, ДТБР - двойной туннельный барьер с резонансным туннелированием.
В случае, показанном вверху, транзистор резко открывается лишь при определенном (резонансном) значении напряжения между базой и эмиттером. В случае, показанном внизу, транзистор открывается лишь при определенном (резонансном) значении напряжения между базой и коллектором. А в случае, показанном посредине, открывание транзистора происходит лишь при определенном (резонансном) значении напряжения между эмиттером и коллектором.
или другие аналогичные комбинации толщиной порядка единиц нанометра) в любую область биполярного гетеротранзистора – в эмиттер, базу или в коллектор. Соответствующие энергетические диаграммы показаны на
рис.
8.8. Здесь обозначения такие же, как и на
рис.
8.6, ДТБР - двойной туннельный барьер с резонансным туннелированием.
В случае, показанном вверху, транзистор резко открывается лишь при определенном (резонансном) значении напряжения между базой и эмиттером. В случае, показанном внизу, транзистор открывается лишь при определенном (резонансном) значении напряжения между базой и коллектором. А в случае, показанном посредине, открывание транзистора происходит лишь при определенном (резонансном) значении напряжения между эмиттером и коллектором.
Во всех трех случаях достигаются фронты исходного сигнала, значительно более крутые, чем при отсутствии двойного туннельного барьера.
На рис. 8.9 и рис. 8.10 показаны примеры структуры гетеротранзисторов со встроенным ДТБР.
Такие гетеротранзисторы сейчас интенсивно исследуются. Схемотехника сверхвысокочастотных схем на гетеротранзисторах с резонансным туннелированием только разрабатывается. Пока еще нет даже устоявшихся способов изображения таких новейших транзисторов в схемах.
Гетеротранзисторы на "горячих" электронах
Интересными новыми разработками являются также гетеротранзисторы на "горячих" электронах. Идея униполярных (без  -переходов) транзисторов на "горячих" электронах (англ. Hot Electron Transistor – НЕТ), которую объясняет
рис.
8.11, была высказана еще в 60-х гг. ХХ в. Она состоит в использовании свойств полупроводниковой структуры
-переходов) транзисторов на "горячих" электронах (англ. Hot Electron Transistor – НЕТ), которую объясняет
рис.
8.11, была высказана еще в 60-х гг. ХХ в. Она состоит в использовании свойств полупроводниковой структуры  , где высоколегированная
, где высоколегированная  -область выполняет роль базы транзистора. На границе раздела эмиттер/база возникает перепад потенциала. Благодаря этому часть потенциальной энергии электронов проводимости, инжектируемых в базу, превращается в кинетическую энергию, которая намного больше энергии теплового движения электронов.
-область выполняет роль базы транзистора. На границе раздела эмиттер/база возникает перепад потенциала. Благодаря этому часть потенциальной энергии электронов проводимости, инжектируемых в базу, превращается в кинетическую энергию, которая намного больше энергии теплового движения электронов.
Распределение инжектированных в базу электронов по энергиям значительно отличается от равновесного распределения Максвелла. И поэтому такие электроны называют "горячими". Если толщина базовой области меньше длины свободного пробега, то такие "горячие" электроны пролетают сквозь базу в коллектор практически без рассеяний, обеспечивая высокий коэффициент передачи потока инжектированных электронов в коллектор.
Однако идея транзисторов на горячих электронах стала эффективной лишь на "наноэлектронном" этапе развития при использовании гетероструктур со сверхтонкими слоями.
В профессиональных журналах описано много вариантов реализации гетеротранзисторов на "горячих" электронах – со структурами  ,
,  ,
,  и другими. Одним из наилучших оказался вариант транзистора на двойной гетероструктуре: "эмиттер из
и другими. Одним из наилучших оказался вариант транзистора на двойной гетероструктуре: "эмиттер из  / база из
/ база из  толщиной около 10 нм / коллектор из
толщиной около 10 нм / коллектор из  ". Энергетическая диаграмма, на которой изображены профили лишь "дна" зон проводимости такого транзистора, показана на
рис.
8.12 слева.
". Энергетическая диаграмма, на которой изображены профили лишь "дна" зон проводимости такого транзистора, показана на
рис.
8.12 слева.
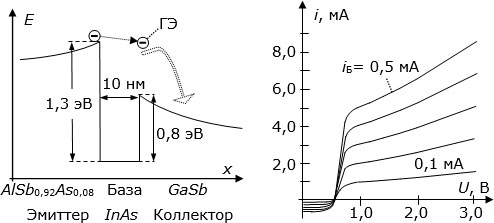
Рис. 8.12. Слева – профиль "дна" зоны проводимости гетеротранзистора на "горячих" электронах (ГЭ) со структурой, описанной в тексте. Справа – передаточные характеристики такого транзистора в схеме с общим эмиттером при различных значениях тока базы
Валентные зоны для упрощения не показаны. Перепад потенциала зоны проводимости на границе раздела эмиттер/база составляет здесь 1,3 эВ. Приблизительно такую кинетическую энергию получают "горячие" электроны, инжектированные из эмиттера в базу. Пролетая тонкий (толщиной приблизительно 10 нм) слой базы практически без рассеяний и, следовательно, без потери энергии, они легко преодолевают потенциальный барьер высотой 0,8 эВ на границе раздела база/коллектор.
На
рис.
8.12 справа показаны типичные передаточные характеристики такого транзистора в схеме с общим эмиттером при температуре 300 К. Вдоль горизонтали здесь отложено напряжение  между коллектором и эмиттером, вдоль вертикали – ток коллектора. Характеристики приведены для разных значений электрического тока базы, начиная от 100 мкА с шагом в 100 мкА. Коэффициент усиления тока превышает 10 при частотах в сотни ГГц при очень малом собственном шуме. А коэффициент усиления мощности может быть еще во много раз больше.
между коллектором и эмиттером, вдоль вертикали – ток коллектора. Характеристики приведены для разных значений электрического тока базы, начиная от 100 мкА с шагом в 100 мкА. Коэффициент усиления тока превышает 10 при частотах в сотни ГГц при очень малом собственном шуме. А коэффициент усиления мощности может быть еще во много раз больше.
Малое время реакции (порядка 0,1 пс) в таких транзисторах обусловлено тем, что они используют основные носители заряда и баллистический характер их пролета сквозь базу, имеют низкое электрическое сопротивление базовой области и малые значения электрической емкости эмиттерного и коллекторного барьеров.
Характеристики гетеротранзисторов на "горячих" электронах дополнительно можно улучшить с использованием двойного резонансного туннельного барьера, как в биполярных гетеротранзисторах. В частности, когда ДТБР встраивается в область эмиттера, то резонансное туннелирование обеспечивает инжекцию в базу "горячих" электронов с очень малым "разбросом" энергий, что предопределяет их практически одновременный пролет сквозь базу и соответственно крутые (субпикосекундные) фронты сигналов при переключениях транзистора.